内存中FBGA是什么及作用介绍
发布时间:2013-05-14 15:26:18 作者:佚名  我要评论
我要评论
FBGA是一种在底部有焊球的面阵引脚结构,使封装所需的安装面积接近于芯片尺寸,FBGA作为新一代的芯片封装技术,在BGA、TSOP的基础上,FBGA的性能又有了革命性的提升
FBGA是一种在底部有焊球的面阵引脚结构,使封装所需的安装面积接近于芯片尺寸。
BGA发展来的FBGA封装技术正在逐渐展现它生力军本色,金士顿、勤茂科技等领先内存制造商已经推出了采用FBGA封装技术的内存产品。
FBGA作为新一代的芯片封装技术,在BGA、TSOP的基础上,FBGA的性能又有了革命性的提升。FBGA封装可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,绝对尺寸也仅有32平方毫米,约为普通的BGA的1/3,仅仅相当于TSOP内存芯片面积的1/6。这样在相同体积下,内存条可以装入更多的芯片,从而增大单条容量。
也就是说,与BGA封装相比,同等空间下FBGA封装可以将存储容量提高三倍,展示了三种封装技术内存芯片的比较,从中我们可以清楚的看到内存芯片封装技术正向着更小的体积方向发展。
FBGA封装内存不但体积小,同时也更薄,其金属基板到散热体的最有效散热路径仅有0.2mm,大大提高了内存芯片在长时间运行后的可靠性,线路阻抗显著减小,芯片速度也随之得到大幅度的提高。FBGA封装的电气性能和可靠性也相比BGA、TOSP有相当大的提高。
在相同的芯片面积下FBGA所能达到的引脚数明显的要比TSOP、BGA引脚数多的多(TSOP最多304根,BGA以600根为限,FBGA原则上可以制造1000根),这样它可支持I∕O端口的数目就增加了很多。
此外,FBGA封装内存芯片的中心引脚形式有效的缩短了信号的传导距离,其衰减随之减少,芯片的抗干扰、抗噪性能也能得到大幅提升,这也使得FBGA的存取时间比BGA改善15%-20%。
在FBGA的封装方式中,内存颗粒是通过一个个锡球焊接在PCB板上,由于焊点和PCB板的接触面积较大,所以内存芯片在运行中所产生的热量可以很容易地传导到PCB板上并散发出去;而传统的TSOP封装方式中,内存芯片是通过芯片引脚焊在PCB板上的,焊点和PCB板的接触面积较小,使得芯片向PCB板传热就相对困难。
FBGA封装可以从背面散热,且热效率良好,FBGA的热阻为35℃/W,而TSOP热阻40℃/W。测试结果显示,运用FBGA封装的内存可使传导到PCB板上的热量高达88.4%,而TSOP内存中传导到PCB板上的热量能为71.3%。另外由于FBGA芯片结构紧凑,电路冗余度低,因此它也省去了很多不必要的电功率消耗,致使芯片耗电量和工作温度相对降低。
目前内存颗粒厂在制造DDR333和DDR400内存的时候均采用0.175微米制造工艺,良品率比较低。而如果将制造工艺提升到0.15甚至0.13微米的话,良品率将大大提高。而要达到这种工艺水平,采用FBGA封装方式则是不可避免的。因此FBGA封装的高性能内存是大势所趋。
FBGA仅仅是元件的一种封装形式,只为减小体积,同时稍微提高一点速度。你的计算机根本不需要考虑这个问题,只需要安装合适的驱动即可。内存只需要根性的内存速度即可。
BGA发展来的FBGA封装技术正在逐渐展现它生力军本色,金士顿、勤茂科技等领先内存制造商已经推出了采用FBGA封装技术的内存产品。
FBGA作为新一代的芯片封装技术,在BGA、TSOP的基础上,FBGA的性能又有了革命性的提升。FBGA封装可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,绝对尺寸也仅有32平方毫米,约为普通的BGA的1/3,仅仅相当于TSOP内存芯片面积的1/6。这样在相同体积下,内存条可以装入更多的芯片,从而增大单条容量。
也就是说,与BGA封装相比,同等空间下FBGA封装可以将存储容量提高三倍,展示了三种封装技术内存芯片的比较,从中我们可以清楚的看到内存芯片封装技术正向着更小的体积方向发展。
FBGA封装内存不但体积小,同时也更薄,其金属基板到散热体的最有效散热路径仅有0.2mm,大大提高了内存芯片在长时间运行后的可靠性,线路阻抗显著减小,芯片速度也随之得到大幅度的提高。FBGA封装的电气性能和可靠性也相比BGA、TOSP有相当大的提高。
在相同的芯片面积下FBGA所能达到的引脚数明显的要比TSOP、BGA引脚数多的多(TSOP最多304根,BGA以600根为限,FBGA原则上可以制造1000根),这样它可支持I∕O端口的数目就增加了很多。
此外,FBGA封装内存芯片的中心引脚形式有效的缩短了信号的传导距离,其衰减随之减少,芯片的抗干扰、抗噪性能也能得到大幅提升,这也使得FBGA的存取时间比BGA改善15%-20%。
在FBGA的封装方式中,内存颗粒是通过一个个锡球焊接在PCB板上,由于焊点和PCB板的接触面积较大,所以内存芯片在运行中所产生的热量可以很容易地传导到PCB板上并散发出去;而传统的TSOP封装方式中,内存芯片是通过芯片引脚焊在PCB板上的,焊点和PCB板的接触面积较小,使得芯片向PCB板传热就相对困难。
FBGA封装可以从背面散热,且热效率良好,FBGA的热阻为35℃/W,而TSOP热阻40℃/W。测试结果显示,运用FBGA封装的内存可使传导到PCB板上的热量高达88.4%,而TSOP内存中传导到PCB板上的热量能为71.3%。另外由于FBGA芯片结构紧凑,电路冗余度低,因此它也省去了很多不必要的电功率消耗,致使芯片耗电量和工作温度相对降低。
目前内存颗粒厂在制造DDR333和DDR400内存的时候均采用0.175微米制造工艺,良品率比较低。而如果将制造工艺提升到0.15甚至0.13微米的话,良品率将大大提高。而要达到这种工艺水平,采用FBGA封装方式则是不可避免的。因此FBGA封装的高性能内存是大势所趋。
FBGA仅仅是元件的一种封装形式,只为减小体积,同时稍微提高一点速度。你的计算机根本不需要考虑这个问题,只需要安装合适的驱动即可。内存只需要根性的内存速度即可。
相关文章

全球首发!芝奇256GB (64GBx4) DDR5-6000 CL32超频内存套装来了
世界知名超频内存及高端电竞设备领导品牌,芝奇国际昨日宣布领先全球推出 DDR5-6000 CL32 256GB (64GBx4) 超大容量超频内存套装,下面我们来看看性能如何2025-04-22
lpddr5与ddr5内存类型的区别及内存频率对电脑性能的影响
最近在研究内存,发现有不少朋友在问LPDDR5和DDR5到底有什么区别,今天就来跟大家聊聊这两种内存的差异,帮助大家更好地选择适合自己的产品2025-03-07
全球首款双档EXPO配置内存! 佰维发布DW100 OCLAB联名款
佰维 Biwin 昨日宣布推出世界首款双档 EXPO 配置内存条 DW100 OCLAB 联名版,该内存条采用黑底缀金的优雅外观设计,专为 AMD X870 (E)、B850 平台优化2025-03-03 今天给大家种草一款近期大热的内存条——金泰克kimtigo 白月光系列 DDR5 6400 32GB(16Gx2)套装,这款内存条不仅拥有超高的频率和容量,更采用了顶级的海力士A-die颗粒,2025-02-20
今天给大家种草一款近期大热的内存条——金泰克kimtigo 白月光系列 DDR5 6400 32GB(16Gx2)套装,这款内存条不仅拥有超高的频率和容量,更采用了顶级的海力士A-die颗粒,2025-02-20
ECC 内存和非 ECC内存有什么区别?内存选择的关键技术解析
ECC(内存和非ECC内存主要在功能、适用场景、传输速率以及价格等方面有所区别,下面我们就来看看详细介绍2025-02-19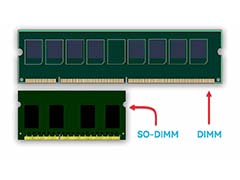 RAM主要分为SRAM和DRAM两种类型,SRAM 和 DRAM 这两种类型的 RAM 目前仍然被广泛应用,但适合于各自不同的使用场景,下面本文将详细解读各类 RAM 及其特性2025-02-19
RAM主要分为SRAM和DRAM两种类型,SRAM 和 DRAM 这两种类型的 RAM 目前仍然被广泛应用,但适合于各自不同的使用场景,下面本文将详细解读各类 RAM 及其特性2025-02-19
CL28超低延迟加持 频率最高8200! 金百达星刃DDR5 6000MHz C28内存实测
今天上手的这对星刃DDR5内存套装,别看频率只有6000MHz,但时序却非常低,为CL28-35-35-77,下面就一同看看该内存的具体表现2025-02-14 亦逍遥系列内存条融汇UDIMM与SODIMM双规格设计,以无与伦比的适应性,满足从桌面工作站到移动计算平台的广泛需求,详细请看下文测评2025-01-24
亦逍遥系列内存条融汇UDIMM与SODIMM双规格设计,以无与伦比的适应性,满足从桌面工作站到移动计算平台的广泛需求,详细请看下文测评2025-01-24
一键9000MT/s! 金士顿 FURY Renegade DDR5 RGB CUDIMM内存评测
Intel最新一代的酷睿Ultra 200S处理器已经上市销售,这一代处理器新增了对DDR5 CUDIMM内存的支持,可以达到比上代高出不少的内存频率,而内存厂商们也在第一时间跟进,推出2025-01-24
首款国产DDR5 32GB内存强不强? 金百达银爵DDR5调试+超频测试
首款国产DDR5内存上线了,前首发的国产DDR5内存有2个品牌,分别是金百达和光威,这次上手实测的就是搭载国产颗粒的金百达银爵16GB*2 DDR5 6000的套装2025-01-08







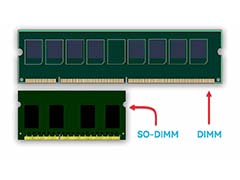




最新评论